- Projekttitel: Next Gen TSV – Next generation of through-silicon via (TSV)
- Projektleiter: Ali Roshanghias
- Projektkonsortium: SAL, ams-OSRAM AG
- Laufzeit: Juli 2023 – Juni 2026
Next Gen TSV
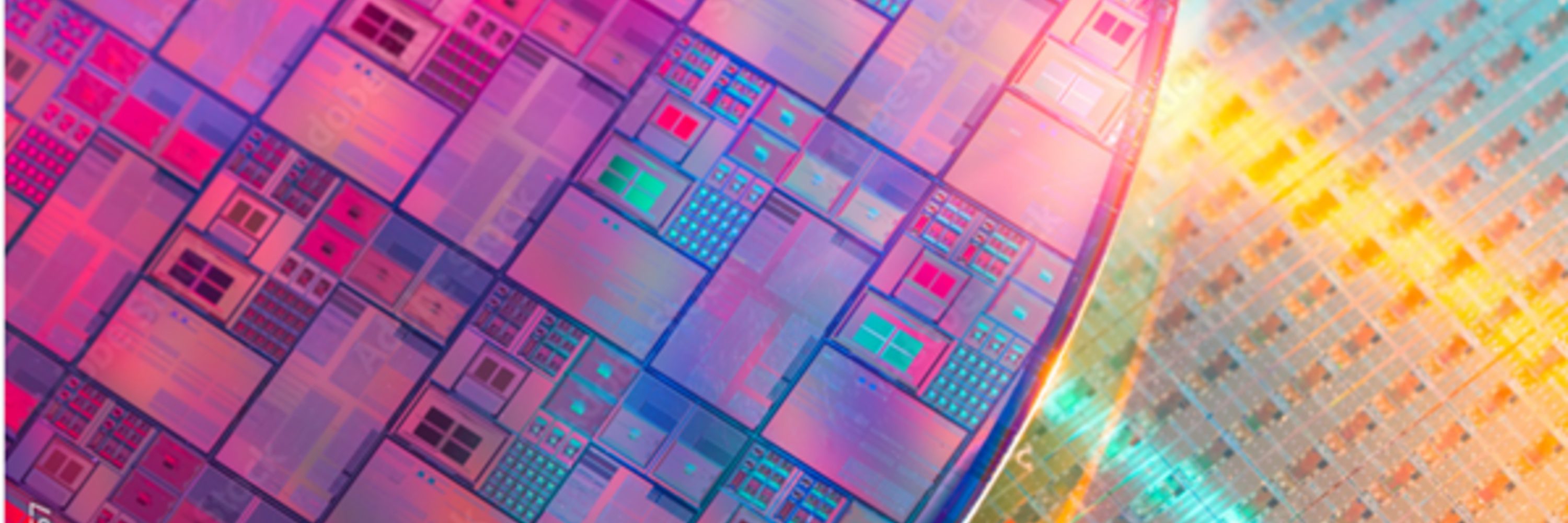
Die 2,5- und 3D-Integration unter Verwendung von TSV-Wafern (Through-Silicon Via, Silizium-Durchkontaktierung) hat in den letzten Jahren sowohl in Front-End-Fertigungsanlagen als auch im Back-End-Packaging viel Aufmerksamkeit auf sich gezogen. In diesem Projekt arbeiten SAL und Projektpartner ams-OSRAM AG an der Entwicklung von TSV-Wafer-Integrationsprozessen wie temporärem Bonden, Via Filling, Thinning und Debonding – eigens zugeschnitten für fortgeschrittene Sensorlösungen. Die Auswahl von Bonding- und Filling-Technologien sowie von Materialen, die mit der TSV-Verarbeitungstemperatur kompatibel sind, erfolgt ebenfalls im Projekt. Die Bewertung umfasst die Simulation, Wafer-Processing in der Reinraumumgebung sowie eine Zuverlässigkeitsanalyse.
Projektziele
- Etablierung von Prozessen für die TSV-Fabrikation, den Schutz, die Integration und die Handhabung
- Vorschläge für das Füllen der Durchkontaktierung nach der TSV-Verarbeitung
- Anpassung von temporären Bonding-Technologien für eine hocheffiziente TSV-Verarbeitung
Projektfakten
Ihr Ansprechpartner

Dr. Ali Roshanghias
Head of Research Unit | Heterogeneous Integration Technologies
E-mail: contact@silicon-austria.com




